【嘉勤点评】长电科技的集成封装专利,通过将第一模组和第二模组进行堆叠,可解决目前集成封装结构需要进一步高密度、小型化、多维化、多需求排布设计的需求。
集微网消息,在存储芯片领域,长电科技拥有近20年的成品制造量产经验。近日长电科技通过提供高密度芯片系统集成技术平台,能够满足更小尺寸、更高集成度的Flash产品需求。
为满足多频率和多带宽的应用,异质集成封装结构需要进一步高密度、小型化、多维化。封装结构中存在高度较高的大尺寸封装器件,一种是大数值电感器件、QFN、LGA或BGA等等,同时还会存在对应力较为敏感的滤波器等空腔元件;此外,包含各类芯片的模组组件一般面积与体积也较大,因而集成封装结构需要进行合理排布,以满足各种器件需求并提高整体集成度。
为此,长电科技于2019年9月25日申请了一项名为“集成封装结构”的发明专利(申请号: 201910909470.2),申请人为江苏长电科技股份有限公司。
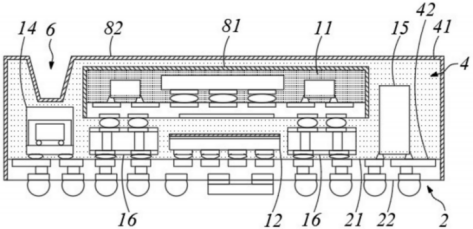
图1 集成封装结构示意图
图1为本发明提出的集成封装结构的示意图,包括主基板2、第一模组11、第二模组12、空腔元件14及大尺寸器件15,其中主基板包括相对设置的主基板第一表面21与主基板第二表面22,第一模组与第二模组堆叠,然后与空腔元件、大尺寸器件水平排布于主基板第一表面且分别与主基板电性连接。
具体的,集成封装结构中,主基板第一表面主要设置各类封装元件,连接集成封装结构下方的PCB板等器件。通过第一模组与第二模组的至少一次堆叠,来减少集成封装结构中的两个或多个模组占用的面积和空间,同时将高度较高的大尺寸器件及对应力敏感的空腔元件与堆叠后的模组组合水平排布,可合理降低集成封装结构内部封装元件组合后的整体高度,使得集成封装结构整体空间更为紧凑、内部结构更加集成化。
空腔元件的空腔一般朝上设置,在塑封层第一表面41对应空腔元件的位置处开设有开口槽6,且至少部分开口槽在空腔元件的正上方,使其上方的塑封层被挖空,从而减少热胀冷缩作用下塑封层对空腔元件中空腔的应力作用,避免空腔元件受到不良应力破坏。本实例中开口槽完全位于空腔元件的上方,并与空腔位置对应,即开口槽沿着空腔元件的中轴线对称分布,由此,可均匀降低空腔元件受到的应力作用,应力缓解效果最佳;同时开口槽形状为倒梯形,塑封层塑封形成后,倒梯形的开口槽使得脱模工艺快速方便。
简而言之,长电科技的集成封装专利,通过将第一模组和第二模组进行堆叠,可解决目前集成封装结构需要进一步高密度、小型化、多维化、多需求排布设计的需求。
随着芯片不断向微型化发展,先进的封测技术也成为了未来存储技术的重要发展方向。长电科技作为中国封测领域的龙头企业,将在先进封测领域持续突破创新,致力于为客户提供优质、全面的服务,助力存储产业发展。
关于嘉勤
深圳市嘉勤知识产权代理有限公司由曾在华为等世界500强企业工作多年的知识产权专家、律师、专利代理人组成,熟悉中欧美知识产权法律理论和实务,在全球知识产权申请、布局、诉讼、许可谈判、交易、运营、标准专利协同创造、专利池建设、展会知识产权、跨境电商知识产权、知识产权海关保护等方面拥有丰富的经验。
(校对/holly)


