【嘉勤点评】恩腾半导体发明的晶片表面污染的清洗方案,通过利用臭氧作为洗涤的原料,减少了硫酸、盐酸等物质的使用量,从而减轻了对后续废液处理的难度,同时采用该方案中的方法也表现出更好的洁净效果。
集微网消息,飞鹿股份发布公告,公司全资子公司飞鹿股份拟合计以3260万元对恩腾半导体增资。同时,公告称,恩腾半导体在半导体清洗设备行业拥有较强的技术研发能力及渠道资源,有能力为国内主流半导体制造企业供货。
随着半导体制造设备的微细化和高集成化的发展,晶片表面污染对制造、设备特性和可靠性产生的影响正在逐渐扩大,而设备加工环境变得愈加复杂,污染物的清除也更加困难。
很多电子器件分析数字显示,在仪器产生不良现象的原因中,70%以上是因为表面污染。因此,目前制造设备最关心的是能控制晶片表面的污染到什么程度,最大的难关是消除污染物。
目前,晶片及半导体制造工艺使用的湿洗工艺使用的是1970年代Kern提出的RCA洗涤方法,这种湿洗法对从硅表面去除粒子、金属杂质和自然氧化膜很有效,与其他清洁方法相比具有较高的生产率。
但尽管如此,由于RCA清洗方法使用了大量的化学清洗剂,所以存在着化学废水处理难以及环境管制等问题。为此,恩腾半导体在2020年12月28日申请了一项名为“一种晶片表面污染清洗方法”的发明专利(申请号:202011573209.9),申请人为苏州恩腾半导体科技有限公司。
根据该专利目前公开的相关资料,让我们一起来看看这项技术方案吧。
该专利中的方案主要包括以下步骤:
1)首先,将晶片置于常温下的超纯水中清洗,清洗时间为300秒;
2)其次,将晶片移至氨水、双氧水混合溶液中进行超声波清洗,温度控制在60-70摄氏度,清洗时间同样为300秒;
3)将晶片进而移至常温的超纯水中漂洗,清洗时间为300秒;
4)将晶片移至盐酸、双氧水混合溶液中进行清洗,温度为常温,清洗时间为300秒;
5)将晶片移至常温的超纯水中进行超声波漂洗,这种超纯水内含有10-20PPM浓度的臭氧,清洗时间为300秒;
6)最后,将晶片进行干燥,该方案中使用的干燥剂为SUS316。
该专利中对上述方案进行测试后发现,臭氧浓度越大并且处理时间越长,则初期氧化膜的厚度就越厚,而倘若初期氧化膜越厚,厚度增加分量就越少。因此,在晶片表面进行臭氧处理时生成的氧化膜,通过将晶片表面亲水化,污染物质将无法吸附。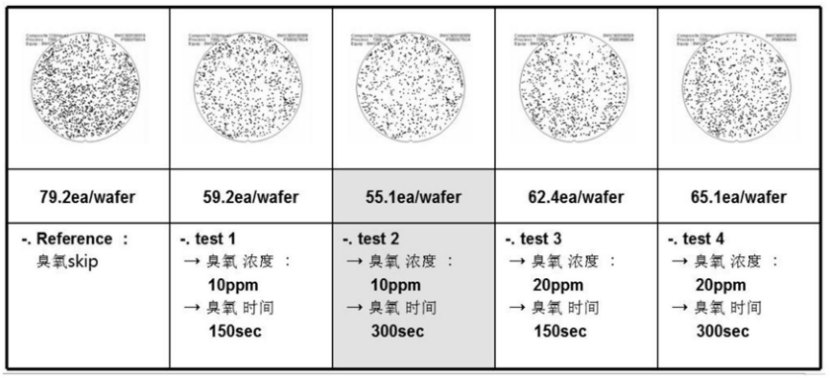
如上图所示,为一些晶片的清洗数据,可以看到,这种利用臭氧来进行晶片的洗涤方案,跟以往清洗方法相比,不仅减少了化学液H2SO4、HCl、HF及NH4OH的使用量,同时也减轻了对后续废液处理的难度,同时采用该方法表现出更好的洁净效果。
以上就是恩腾半导体发明的晶片表面污染的清洗方案,在该方案中,通过利用臭氧作为洗涤的原料,减少了硫酸、盐酸等物质的使用量,从而减轻了对后续废液处理的难度,同时采用该方案中的方法也表现出更好的洁净效果。


