【嘉勤点评】中芯国际发明的半导体器件形成方案,不仅可以节约半导体器件中掩膜层的材料,降低生产成本,并可以增加晕环区对轻掺杂区和源漏区的横向扩散的抑制作用,以避免器件的漏电。同时,该方案解决了倾斜离子注入无效的问题,提高了半导体器件的性能。
集微网消息,金属-氧化物-半导体(MOS)晶体管,是现代集成电路中的重要器件,以N沟道增强型MOS场效应管为例,其利用栅极电压来控制“感应电荷”的数量,以改变由这些“感应电荷”形成的导电沟道的状况,然后达到控制漏极电流的目的。
我们知道,MOS晶体管的基本结构一般包括半导体衬底,位于半导体衬底表面上的栅极结构和位于所述栅极结构两侧的半导体衬底内的源漏掺杂区。
但是,现有的制造MOS晶体管的方法制造的半导体器件存在漏电的问题,且生产出来的半导体器件的性能仍有待提高。为此,中芯国际在2020年2月26日申请了一项名为“半导体器件及其形成方法”的发明专利(申请号:202010120136.1),申请人为中芯国际集成电路制造(上海)有限公司。
根据目前该专利公开的相关资料,让我们一起来看看这项半导体器件的形成方法吧。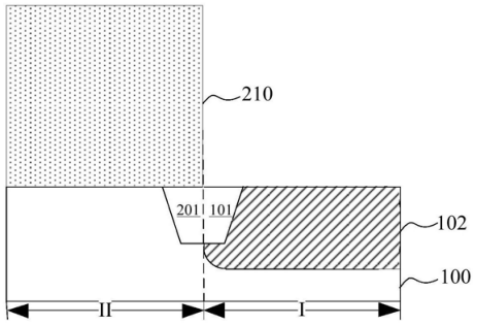
如上图,为利用现有技术形成的半导体器件的结构示意图,该半导体衬底100包括第一区I和第二区II。第一区包括第一有源区和包围第一有源区的第一隔离区,其中,第一隔离区中的第一边缘隔离区101与第二区相邻。
第二区包括第二有源区和包围第二有源区的第二隔离区,第二隔离区中的第二边缘隔离区201与第一区相邻。同时,对于相邻的第一区和第二区而言,相邻的第一边缘隔离区和第二边缘隔离区邻接。
此外,在第二区上设置有第一光阻层210,并以第一光阻层为掩膜对第一区执行第一阱离子注入,以在半导体衬底中形成第一阱区102。但是当采用第一阱离子注入时所用的光阻层作为第一倾斜离子注入的掩膜层时,由于该光阻层的厚度较大,会对第一倾斜离子注入形成阻挡,进而导致漏电流激增,降低了半导体器件的性能。

为解决该问题,该专利中发明了一种半导体器件的形成方法,如上图所示。首先,需要提供半导体衬底,包括第一区(第一有源区和第一隔离区)以及第二区,并在半导体衬底的第一区上形成第一栅极结构,第一栅极结构沿第一方向横跨第一有源区。
其次,形成第一栅极结构之后,在第二区上形成第一阱区掩膜层,该第一阱区掩膜层会延伸至第一边缘隔离区的部分表面上。接着,以第一阱区掩膜层为掩膜对第一区执行第一阱离子注入,并在第一区中形成包围第一有源区的第一阱区。
最后,以第一阱区掩膜层和第一栅极结构为掩膜,采用第一倾斜离子注入在第一栅极结构两侧的第一有源区中,从而形成第一晕环区,需要注意的是,第一倾斜离子注入的注入方向分别与第一方向和第一栅极结构的宽度方向之间的夹角为锐角。
在这种方案中,第一阱区掩膜层中的第一开口具有相对于第一侧壁区朝向第二区凸出的第二侧壁区,且第二侧壁区沿第一栅极结构宽度方向的尺寸大于第一栅极结构的宽度,使得第二侧壁区处的第一阱区掩膜层在沟道宽度方向和沟道长度方向上均向远离第一栅极结构底部的沟道移动。
因此,可以使得第二侧壁区处的第一阱区掩膜层在执行第一倾斜离子注入时所形成的阴影,在沟道宽度方向和沟道长度方向上均向远离第一栅极结构底部的沟道移动,从而可以避免第一倾斜离子注入时的离子注入无效,并可有效提高半导体器件的性能。
以上就是中芯国际发明的半导体器件形成方案,该方案不仅可以节约半导体器件中掩膜层的材料,降低生产成本,并可以增加第一晕环区对第一轻掺杂区和第一源漏区的横向扩散的抑制作用,以避免器件的漏电。同时,解决了倾斜离子注入无效的问题,提高了半导体器件的性能。
关于嘉勤

深圳市嘉勤知识产权代理有限公司由曾在华为等世界500强企业工作多年的知识产权专家、律师、专利代理人组成,熟悉中欧美知识产权法律理论和实务,在全球知识产权申请、布局、诉讼、许可谈判、交易、运营、标准专利协同创造、专利池建设、展会知识产权、跨境电商知识产权、知识产权海关保护等方面拥有丰富的经验。
(校对/holly)


