
集微网消息,自IC产业增长点从传统的计算机及通讯产业转向便携式移动设备,便催动着IC封装技术的持续变革,以满足移动设备功能灵活性、薄化体积、降低成本等特殊要求。在此背景下,作为3D封装的POP(堆叠封装),以一种高集成封装的“身份”登上舞台,并成为逻辑与存储IC集成首选方案。
7月27日,集微网举办了第66期“集微公开课”活动,特邀华天科技(南京)有限公司FC封装研究室总监汪民,围绕“华天科技POP封装方案介绍”主题作分享,详细介绍了POP封装的市场趋势与应用情况,并展示了华天POP封装方案及最新成果——HBPOP,为线上参会嘉宾带来一场精彩的科技盛宴!
华天科技是全球知名的半导体封装测试企业,专注于半导体集成电路和半导体元器件的封装测试业务,为客户提供一流的芯片成品封测一站式服务,涵盖封装设计、封装仿真、引线框架封装、基板封装、晶圆级封装、晶圆测试及功能测试、物流配送等。凭借先进的技术能力、系统级生产和质量把控,华天科技已经成为半导体封测业务的首选品牌。
“首选方案”源于何?
POP作为3D封装的一种形式,已在移动互联网设备、高端便携式设备和智能手机等领域得到了广泛应用。汪民指出:“POP支持上述应用领域对复杂性和功能性的要求,比如具备功能集成、体积小、封装体薄等特点。”
据汪民介绍,POP封装技术是逻辑与存储IC集成首选方案,主要应用于移动设备、智能家居、工业自动化等领域,移动设备为POP技术主要应用领域,占据大部分市场份额。
汪民指出,因POP封装具备较高的晶圆利用率,有助于在移动设备中实现更多的功能;占用较少的基板空间,减小电路板面积;较短的互联实现更快的数据产生速率以及产品整体成本得到降低等优势,可提高终端设备的传输效率、散热性能、图像质量、低延迟、低功耗等性能。
而随着POP技术不断演进,如应用处理器或基带、存储器组合的封装结构,已经被越来越多地应用于高频、高速、低时延、多通路、小体积的网络及无线通讯SoC芯片封装方案中,因此POP封装在“处理器+存储器“、“传感器+控制器”、“无线通信模块”、“摄像头+图像处理器”等集成封装方面具有广泛应用前景。
在半导体技术发展和新兴市场增长的带动下,附加值更高的先进封装正在得到越来越多的应用,封装测试业市场持续向好。从全球先进封装细分市场来看,目前FC封装市场占据主要市场份额——2022年FC封装市场规模达291亿美元,占比先进封装市场份额76.9%。随着5G技术的普及和应用,移动设备市场的不断发展,POP封装市场增加迅速。
在5G、物联网、汽车电子等新兴应用及半导体技术迭代的推动下,华天科技的HBPOP封装技术因此获得极大进展,在与客户应用需求融合的过程中,成功应用在了智能终端、可穿戴设备的存储与处理器结合等封装市场领域。
华天科技HBPOP封装方案
汪民介绍,POP封装从早期的底部可堆叠极小节距BGA (PSvfBGA) 平台,过渡至采用更高速核心和更多 I/O 数量的倒装设计,再到穿塑通孔 (TMV),使芯片/封装比更大、更轻薄基板成为可能,发展到以铜核球(TCB) 热压缩焊接方式来实现更小节距互连增加晶片尺寸而无需增加封装尺寸。
华天科技基于其TMV POP封装方案推出的HBPOP封装方案,通过Interposer+CCSB(铜核锡球)结构设计的实现,在更小尺寸的基础上实现了更优的芯片性能,以满足客户对性能的更高要求。
POP一般由上下两层封装叠加而成,就底层POP封装而言,引线键合正被倒转焊技术所取代。对应更小封装尺寸的要求,推动焊球节距的不断缩小。而为了应对更高的应用需求,在顶层封装中,如LPDDR存储芯片的封装需要包含更多存储芯片,并有更高速度和带宽的要求,这对应着顶层封装也需要具有数目更多的焊球。由于同时要求更大焊球数目和更小封装尺寸,因而降低顶层封装的焊球节距也非常必要。
汪民在公开课上表示,目前POP封装的底层封装结构中,0.4 mm的焊球节距已成普遍,顶层的封装则使用0.5 mm/0.4mm的节距。
而华天科技的HBPOP产品,在底层POP上可以做到0.3mm以下;Interposer层最小可以实现0.27mm,同时实现了更好的产品可靠性和良率表现。
综合焊球间距的变小,POP封装在翘曲的管控上也带来更高的要求。
据汪民介绍,华天科技最新的HBPOP方案已经几经迭代,通过在方案设计能力与经验积累的优势,在POP翘曲问题上进行了很好的管控和实现。
目前,基于工艺的积累与综合实现,华天科技最新的HBPOP封装方案,通过CCSB刷球方式植球、TCB贴 Interposer w/ CCSB、Exposed Die Mold方式进行塑封等关键工艺,实现了工艺流程的简化,同时实现了更薄的产品厚度、更好的翘曲控制等表现。
如采用TCB工艺贴装Interposer时,华天科技对于Bond Head温度Profile管控、Bond Force过程管控、Z方向上的高度控制等工艺关键点,能通过其方案进行很好的管理。
汪民表示,目前华天科技InterposerTCB贴装后高度差异在15um以内。
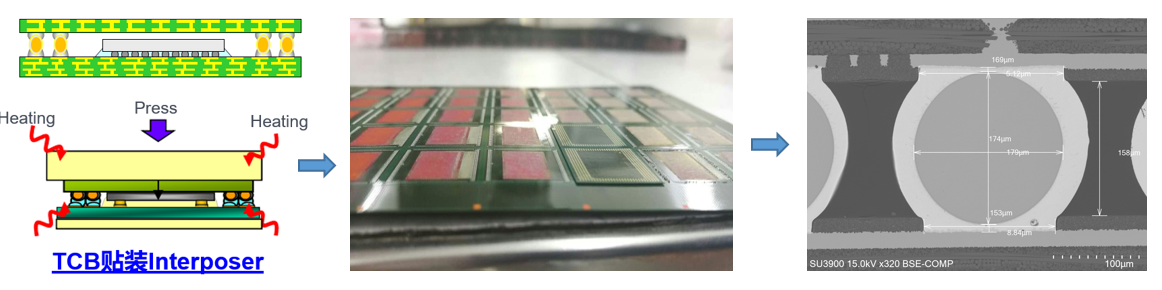
在公开课的结尾,针对华天科技已开发的HBPOP封装技术,汪民表示,新的封装技术依旧需要服务产品,可靠性以及终端上板的良率才是技术成功最重要的衡量标准。经过多年的积累与迭代,华天科技HBPOP封装技术及方案已经呈现出优越的产品表现,未来将是更多行业客户不可忽视的优质选择之一。


